
300ミリウエハーを手動ローディングで行うCMP実験装置です。
エアーバックによるCMP加工、独立したドレスユニット、小径スキャンドレスが可能です。
CMPで予想される様々な高負荷の加工プロセスに対応できるよう、高い装置剛性を保ちながら、最小のフットプリントの設計になっており、非常にコストパフォーマンスの高い装置です。

MEMSプロセスの要求に対応した、マニュアルCMP実験装置です。キャリア軸を独立で持ち、それぞれのパラメーターを設定できるようになっております。コンパクトなレイアウトでありながら、CMP実験には必要十分な機能を備えております。ワークサイズはφ3"からφ6"まで加工できます。

従来の卓上型とは一線を画すCMP専用卓上型実験装置です。経験から培った高剛性と高い信頼性・加工精度などを維持しつつ、非常にコンパクトな装置となっております。
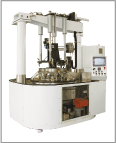
4WAYの両面機です。日本で設計を行い中国で製造しているため、高性能でありながら低コストを実現しています。ラインナップは9Bから24Bまで製作しております。メンテナンスに関しては日本サイドで責任もって行います。


脆弱材料基盤を薄くグラインディングするのに最適な装置です。ワークに対してダメージが少なく、優しい研削が可能で、研磨領域の厚みまで踏み込んだ、研削加工ができます。その結果、従来かかっていた研磨加工も短時間ですみ、歩留まりが飛躍的に向上します。砥石軸受が前後に揺動しながら研削を行います。この時、研削の対応が横方向に逃げるので、加工変質層が浅く、ダメージの少ない研削が可能になりました。
加工中にワークの厚みを自動計測し、そのデータを元に、残りの研削量を装置自身が計算し、再度研削します。オペレータの手を介することなくフルオートで研削が終了します。
サファイヤ基盤、GaN、GaAs、SiC、シリコンウェハーなど割れやすい素材のバック・グラインディングに最適です。


直流ブラシレスモーターの採用により、HEPAフィルターの圧力抵抗増大を検知し、ファン出力を上昇させ、吹出風速を一定に保ちます。
従来型に比べ高機能化・HEPAフィルターの長寿命化を実現しました。

研削液中のスラッジの除去は手間がかかるとともに、放置すると固化しワーク材のキズの原因となります。遠心分離式の研削液状化装置は、全自動でスラッジの除去を行います。たまったスラッジは、自動的にドラム缶に排出されるので、廃棄にも手間がかからず大変便利です。






